
电子显微镜
蔡司Crossbeam 高端FIB-SEM
用于三维
- FIB-SEM分析中的理想三维分辨率
- 离子束和电子束
- 样品制备工具
- 可选配飞秒激光,延长使用时间
- EDS、EBSD、WDS、SIMS等


制备薄片,以便在TEM(透射电子显微镜)或STEM(扫描透射电子显微镜)中进行分析。蔡司Crossbeam为制备TEM薄片提供了完整的解决方案,甚至可以批量制备。
FIB镜筒Ion-sculptor的低电压性能可支持高质量的薄片,并避免易碎样品变质。使用简单的工作流开始工作,等待自动执行。端点检测软件可提供有关薄片厚度的准确信息,让您受益匪浅。
选配的飞秒激光器可用于材料烧蚀、更深入地观察结构以及制备大型样品。
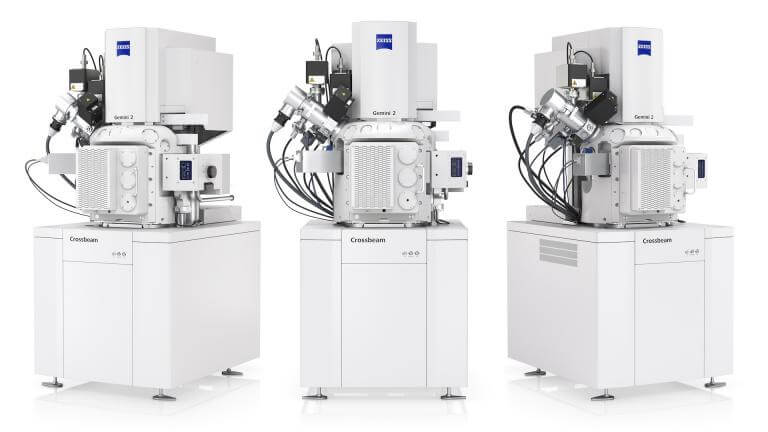
局部截面,例如缺陷部位(薄膜生长缺陷、腐蚀、滞留颗粒等)的截面
TEM薄片制备
透射高分辨率截面研究(STEM)
微观结构或局部缺陷的三维断层扫描
通过定向材料去除加工结

由于生产质量的提高和尖端的表面处理技术,缺陷日益变小、变少。因此,必须使用显微镜方法来发现、定位、准备和调查表面缺陷及其根本原因。本宣传册概述了在失效分析过程中进行有效调查的相关显微镜方法。
在这种情况下,光镜任务由蔡司Smartzoom 5数码显微镜处理,制备和研究由蔡司Crossbeam Laser激光器进行,两个系统通过蔡司ZEN Connect进行关联,以便在FIB-SEM中进行准确的缺陷定位。
要在大样品上找到分布稀疏的小缺陷的根本原因,以进行高效的失效分析,需要一个便捷的工作流包括定位、记录、重新定位、准备和调查感兴趣区域。
聚焦离子東扫描电子显微镜(FIB-SEM)克服了传统材料成像样品制备的局限性。然而,由于电子显微镜的观察视野通常有限,因此有时在光学显微镜上执行定位步骤更为简便。用户因而需要一个能在光学显微镜中定位图像区域,然后在FIB-SEM中检索图像区域的系统。
蔡司ZEN Connect软件解决方案与蔡司ZEN Data Storage的结合正是为了提供这样的功能。蔡司Crossbeam系列的新型飞秒激光器还可在大面积区域内进行特定位置的制备。通过飞秒激光和FIB截面抛光以及EDS分析,上述例子中表面缺陷的原因被确定为碳纤维碎屑。
蔡司ZEN Connect软件解决方案与蔡司ZEN Data Storage的结合正是为了提供这样的功能。蔡司Crossbeam系列的新型飞秒激光器还可在大面积区域内进行特定位置的制备。通过飞秒激光和FIB截面抛光以及EDS分析,上述例子中表面缺陷的原因被确定为碳纤维碎屑。